泽攸科技 | 无掩膜光刻机的分辨率能达到什么水平?影响其分辨率的关键因素有哪些?
发布时间:
2025-08-12
在微纳加工领域,光刻机的分辨率直接决定了器件的精度与性能。泽攸科技凭借自主研发的DMD无掩膜光刻技术,成功突破传统光刻技术的局限,为科研与工业界提供了高分辨率、高灵活性的解决方案。
在微纳加工领域,光刻机的分辨率直接决定了器件的精度与性能。泽攸科技凭借自主研发的DMD无掩膜光刻技术,成功突破传统光刻技术的局限,为科研与工业界提供了高分辨率、高灵活性的解决方案。本文将深入解析泽攸科技无掩膜光刻机的分辨率水平及其关键影响因素,并结合实际应用场景展现其技术优势。
一、泽攸科技无掩膜光刻机的分辨率水平
泽攸科技的无掩膜光刻机采用数字微镜器件(DMD)技术,结合高精度光路设计和先进算法,实现了亚微米级分辨率。根据技术参数显示:
最小特征线宽可达0.5μm(专业版机型),支持0.5μm至2μm范围内的灵活调整;
在常规工艺下,线宽与线宽间隔可稳定控制在1μm以下,并可通过优化工艺进一步提升精度;
支持8位灰度光刻,可生成复杂的三维微结构,满足MEMS、微流控等领域的多样化需求。
二、影响分辨率的关键因素
泽攸科技无掩膜光刻机的分辨率受多维度技术参数与工艺控制的影响,主要包括以下核心要素:
1. DMD芯片与光学系统
DMD芯片的像素密度与微镜尺寸直接影响光刻精度。泽攸科技采用7.56μm像素单元的DMD芯片,通过优化光路设计(如4f双远心结构),将光斑尺寸缩小至亚微米级。
高功率LED光源与高均匀度匀光模块确保曝光能量分布稳定,减少光学衍射对分辨率的限制。
2. 光刻胶与匀胶工艺
光刻胶厚度需严格控制在1μm左右,过厚或过薄均会导致线宽失真。例如,AR-P-5350光刻胶通过预回温与匀胶参数优化(低速/高速旋转结合),实现均匀成膜。
匀胶环境的温湿度稳定性、吸管气泡控制等细节,均对光刻胶的平整度与粘附性至关重要。
3. 曝光参数与算法优化
曝光时间、紫光强度、衰减值等参数需通过实验反复调试。例如,1μm线宽电极的曝光时间需结合剂量优化,确保图形边缘锐利。
内置的光学邻近效应修正(OPC)算法可有效抑制图形失真,提升套刻精度(±0.5μm)。
4. 运动台与对焦精度
高精度直线电机位移台(重复定位精度±0.25μm)与激光主动对焦系统,保障了大面积拼接时的位置一致性。
CCD相机实时监测曝光区域,结合自动调平与物象绑定技术,进一步降低拼接误差。
三、实际应用场景与优势
泽攸科技无掩膜光刻机已在多个领域验证其技术实力:
MEMS器件:助力电子科技大学制备差压传感器,通过灰度光刻实现金字塔状Si结构,响应速度达53μs。
二维材料集成:支持PdSe₂、WS₂等材料的无污染转移与电极刻写,推动高性能光电探测器研发。
仿生光电系统:结合石墨烯异质结,实现宽动态范围(170dB)与快速响应(5ns)的双模成像。
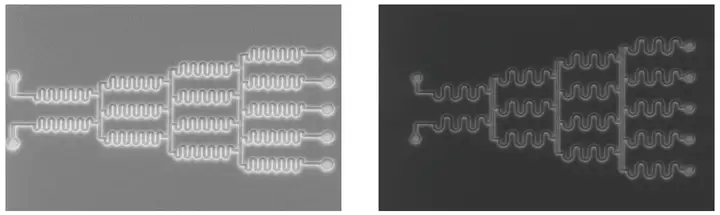





其核心优势在于:
灵活性:支持DXF、GDS等格式,适配科研与小批量生产需求;
高效性:80mm²/min(1μm线宽)的刻写速率,远超传统紫外光刻设备;
易用性:所见即所得的软件界面与自动化功能,降低操作门槛。
四、结语
泽攸科技无掩膜光刻机以0.5μm分辨率为核心竞争力,通过DMD技术、工艺优化与智能化设计,为微纳加工领域提供了高性价比的解决方案。无论是科研探索还是工业应用,其灵活性与精度均处于行业领先地位。如需了解更多技术细节或合作案例,欢迎访问泽攸科技官网 www.zeptools.cn 或联系4009662800。
关键词:无掩膜光刻机、分辨率、1um线宽、DMD技术、MEMS、二维材料、泽攸科技

泽攸科技DMD无掩膜光刻机
相关新闻




